
3D封装成大势所趋,技术挑战不容小觑
随着芯片微缩愈加困难,而市场对芯片高性能的追逐不减,业界开始探索在封装领域寻求突破,所以这几年,诸如2.5D/3D的先进IC封装技术已经成为代工厂、封测厂、IDM、芯片设计厂商以及EDA厂商都竞相关注的一环。

先进封装市场营收及预测情况
不仅仅是芯片制造过程的最后一步,封装正在成为芯片创新的催化剂。3D封装技术允许将不同的芯片如CPU、加速器、内存、IO、电源管理等像乐高积木一样拼凑起来,其主要优势是能实现更好的互连能效,减少访问延迟。例如3D封装技术允许在计算核心附近放置更多的内存,因此可以减少总的布线长度,提高内存访问带宽,改善延迟,提升CPU性能,也因此大大提高了产品级性能、功耗和面积,同时实现对系统架构的全面、重新思考。
如今,3D封装已成为行业顶尖的芯片企业如英特尔、AMD、NVIDIA、苹果等致胜的关键技术之一。虽然以3D IC为代表的异构封装已经成为未来的重点发展方向,但落实新技术要面对不少棘手的问题。相比传统的封装技术,2.5D/3D IC异构封装不仅仅是封装厂技术的革新,更为原有的设计流程、设计工具、仿真工具等带来挑战。
因此,在这样的背景下,3D封装就需要供应链多个环节的支持,包括代工厂、封装厂、EDA厂商、材料厂商等等。
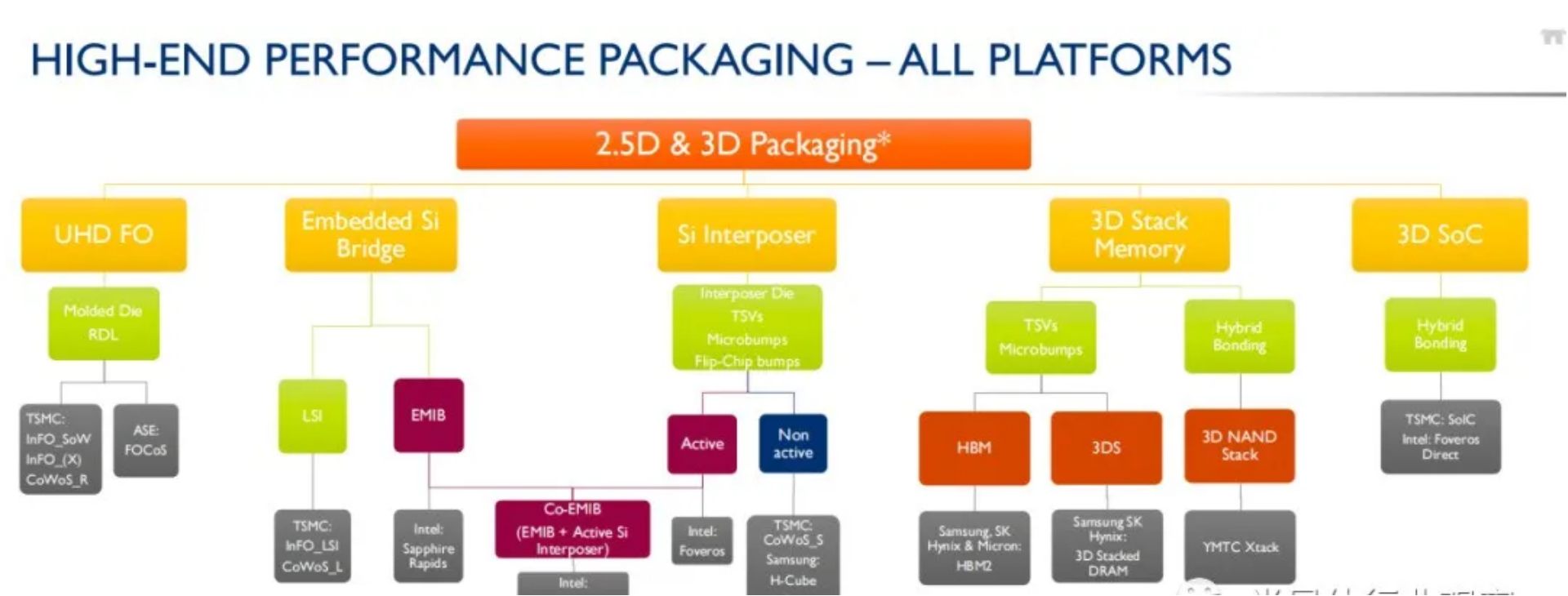
2.5D和3D封装解决方案细分领域一览
将其SoIC(系统整合芯片)、InFO(整合型扇出封装技术)、CoWoS(基板上晶圆上芯片封装) 等2.5D和3D先进封装与芯片堆栈技术整合成为了“3D Fabric”品牌。据台积电2022Q2财报说明会,目前为HPC应用开发的3DIC、SoIC技术已经大部分开始被客户采用。

图源:SemiWiKi
已将Foveros 3D封装技术用于其Ponte Vecchio和Rialto Bridge GPU 以及 Agilex FPGA中,采用 3D Foveros 封装生产的芯片与标准单片(单芯片)芯片设计相比,在某些情况下具有极强的价格竞争力。
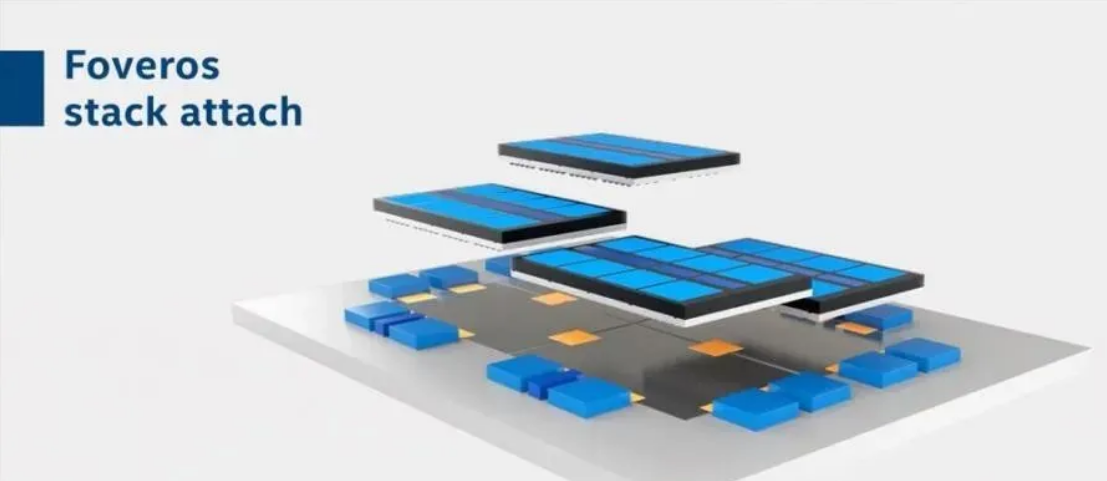
此外,要制造3D芯片,需要在制造设备和原材料领域出现新的技术创新。关键的重要材料之一是用于多枚芯片连接的ABF载板。ABF载板是IC载板中的一种,ABF载板可做线路较细、适合高脚数高讯息传输的IC,具有较高的运算性能,主要用于CPU、GPU、FPGA、ASIC等高运算性能芯片。
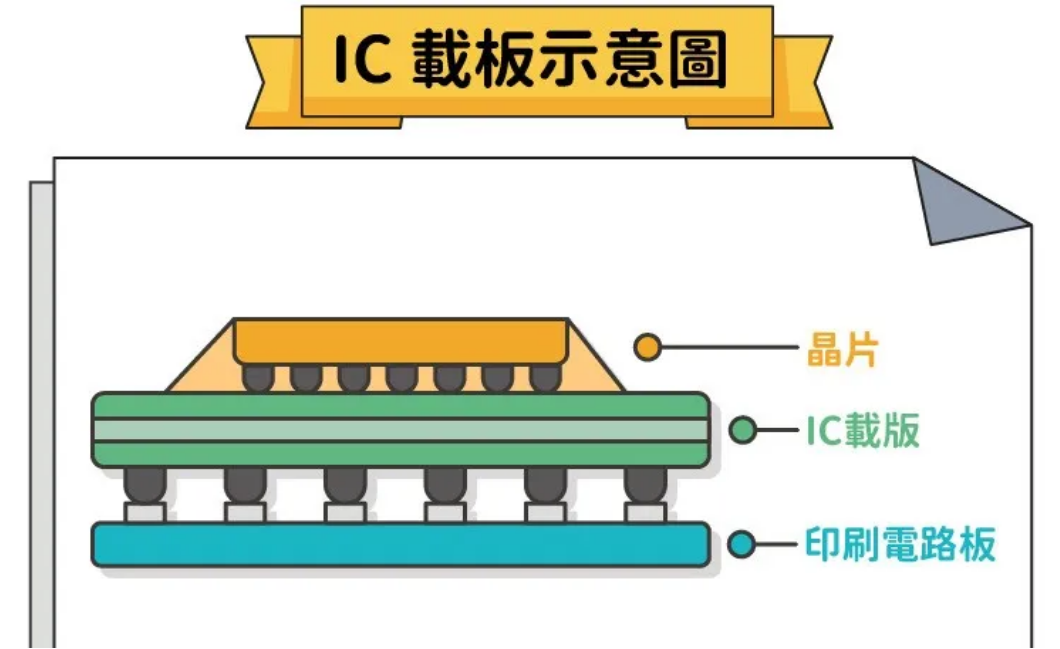
3D IC封装最根本的挑战来自于应用工具数据库的转变。芯片通用的GDS格式与PCB使用的Gerber格式有着根本上的差别,需要重新整合解决方案,以满足先进封装要求。此外,规模增长带来的复杂性也是需要重点关注的问题。
随着整个产业链逐渐日趋完善,并且不断推出各领域新的支持的技术,如2.5D和3D封装技术将成为接下来芯片性能提升过程的中流砥柱,也将是半导体产业的未来。3D封装正在改变半导体世界,这一次将引起全产业链的变革。
分享