
深反应离子刻蚀(DRIE)硅槽是MEMS加工的重要部分,是实现体硅工艺的基石之一。定义是什么?过程如何?有多重要?这是MEMS的入门知识,这里不表述了。这里要讲什么呢?讲MEMS设计从业者都觉得理所当然的傲慢与偏见。觉得加工平台甚至代工厂刻蚀的深硅槽理应既深又直还能瘦,实际去加工后拿到的样片惨不忍睹而落差极大。
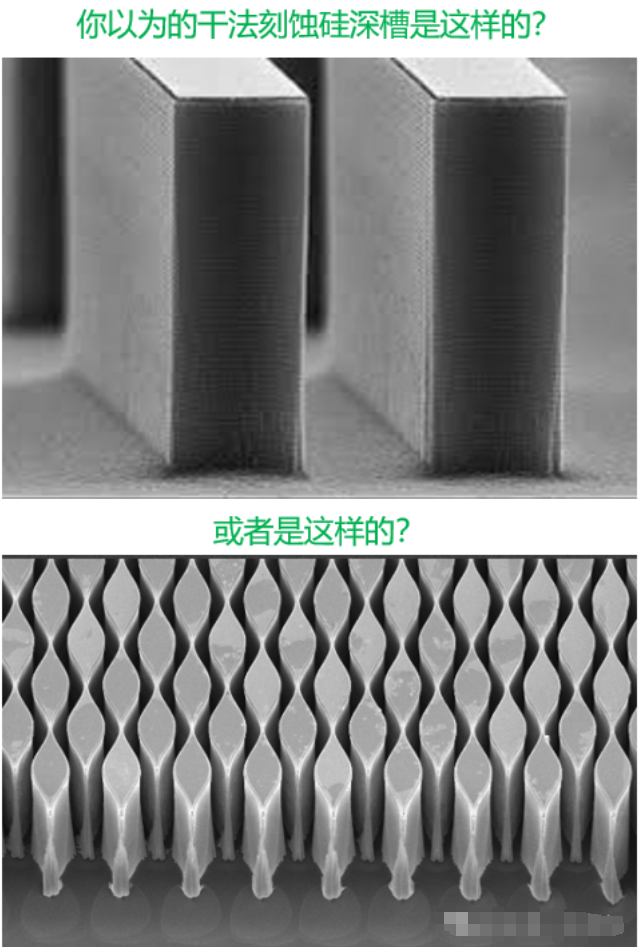

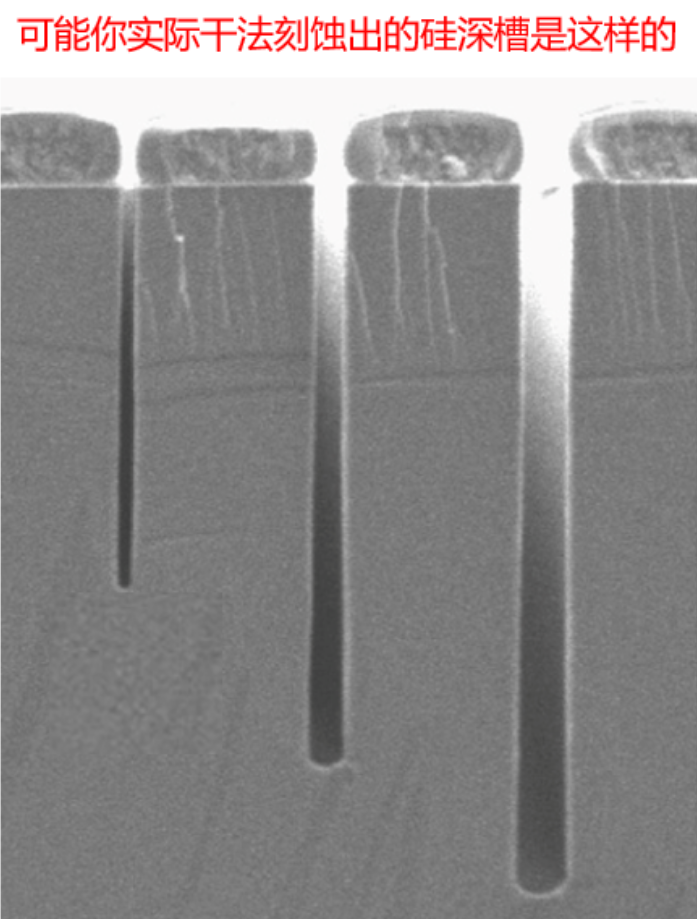

图 干法深硅槽刻蚀:理想 vs 现实
DRIE工艺过程复杂,工艺参数多,包括刻蚀气体流量、钝化气体流量、刻蚀时间/钝化时间比、反应室气压、射频功率以及平板电极功率等,每个参数都会在不同程度上影响刻蚀形貌(侧壁和底部)、垂直度和面内均匀性。常常,形貌、垂直度和面内均匀性很难全部满足,根据特定器件的性能要求,在满足面内均匀性的前提下,牺牲一定的形貌要求去满足高的垂直度要求,反之亦然。
这里,介绍常见的几种DRIE刻蚀中常遇到的问题。

图 DRIE实际产生的问题示意图
底部粗糙/侧壁长草
底部粗糙/侧壁长草问题主要与钝化能力的强弱有关,当刻蚀过程中钝化能力较强时,钝化层厚度较大,刻蚀周期不能够将其有效的去除,从而产生底部粗糙/侧壁长草问题。在其他工艺条件与标准条件一致的情况下,适当降低刻蚀阶段钝化气体流量和时间。
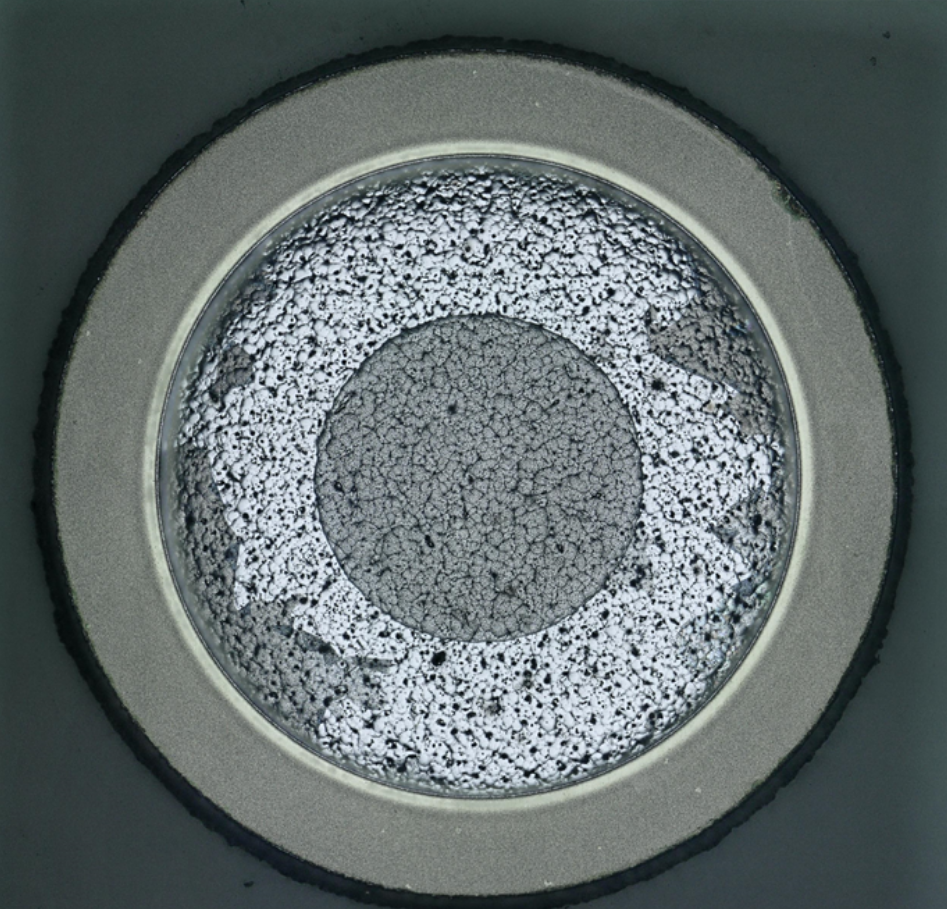
图 深硅槽刻蚀底部粗糙的器件
垂直度问题
垂直度问题分为>90°和<90°情况,刻蚀时间/钝化时间比造成的问题,刻蚀时间/钝化时间比偏大会造成垂直度<90°,即底部宽度更大,刻蚀时间/钝化时间比偏小会造成垂直度>90°,即底部宽度更小,造成缩口现象。通常合适的刻蚀时间/钝化时间是8:3左右,当然也要根据实际的气体流量和设备调试。
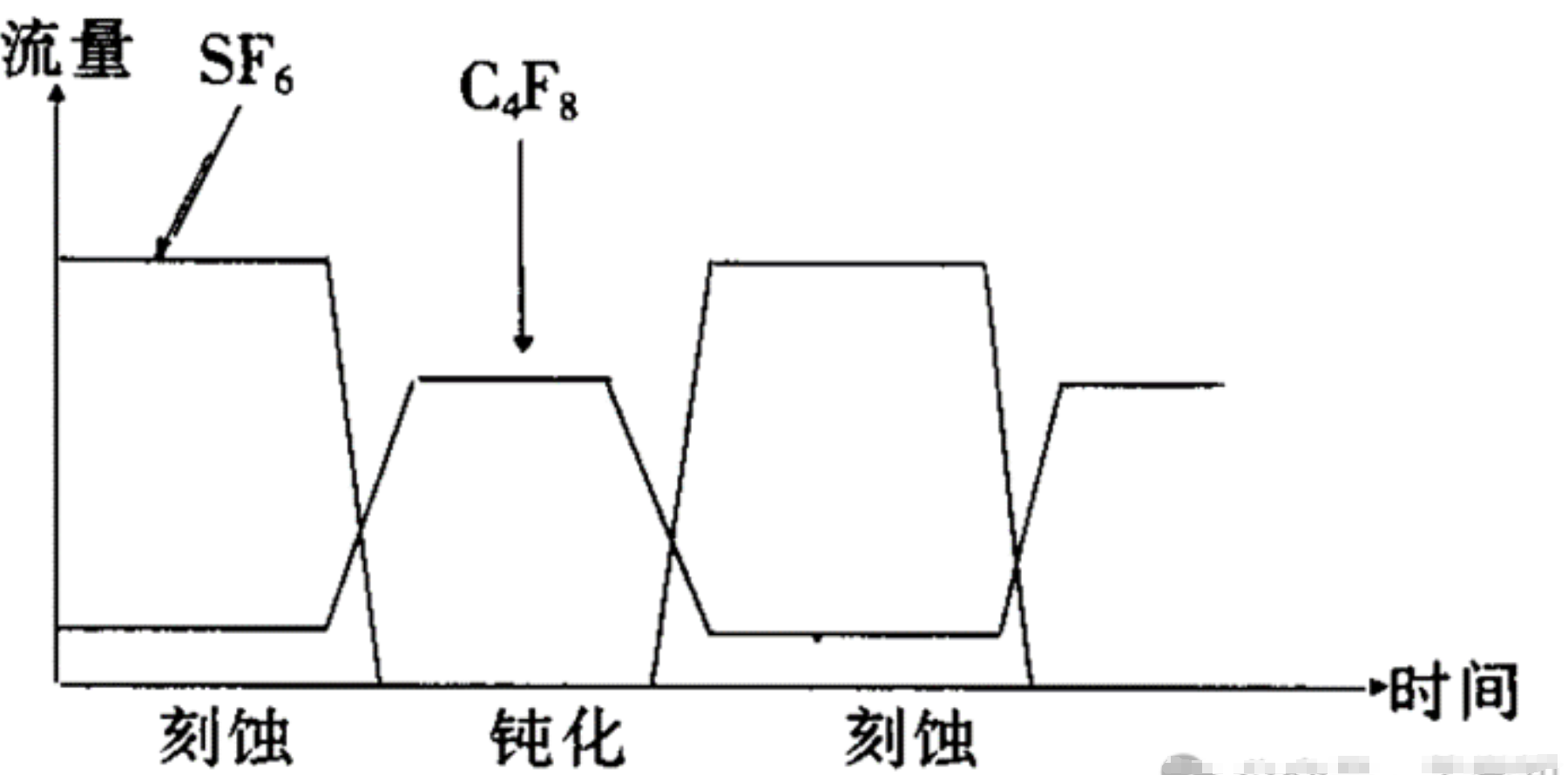
图 刻蚀和钝化时间比示意图
均匀性问题
均匀性问题是最要命的问题,无论什么器件,只要要做量产都必须满足,它除了影响单个器件的性能,更严重的是影响片内的良率。刻蚀均匀性问题的产生是由于反应离子浓度在基片内分布不均匀引起的,主要由反应室压力所决定。即钝化时间反应室压力和刻蚀时间反应室压力应该根据实际的流量来实际调整。
底部不平问题
底部不平问题对于小尺寸压力传感器来说致命的问题,压力传感器是通过硅膜或者硅岛去实现应力的感应,底部不平膜内应力无法做到均匀,从而影响压力输出的线性度和精度。底部不平和开口尺寸相关,开口尺寸越大,中心刻蚀越快,周边越慢。目前还没有查询到文献报道或者实际工厂完全克服此问题,因此对于小尺寸压力传感器必定要用到SOI,用到埋氧层作为自停止层避免底部不平的问题。
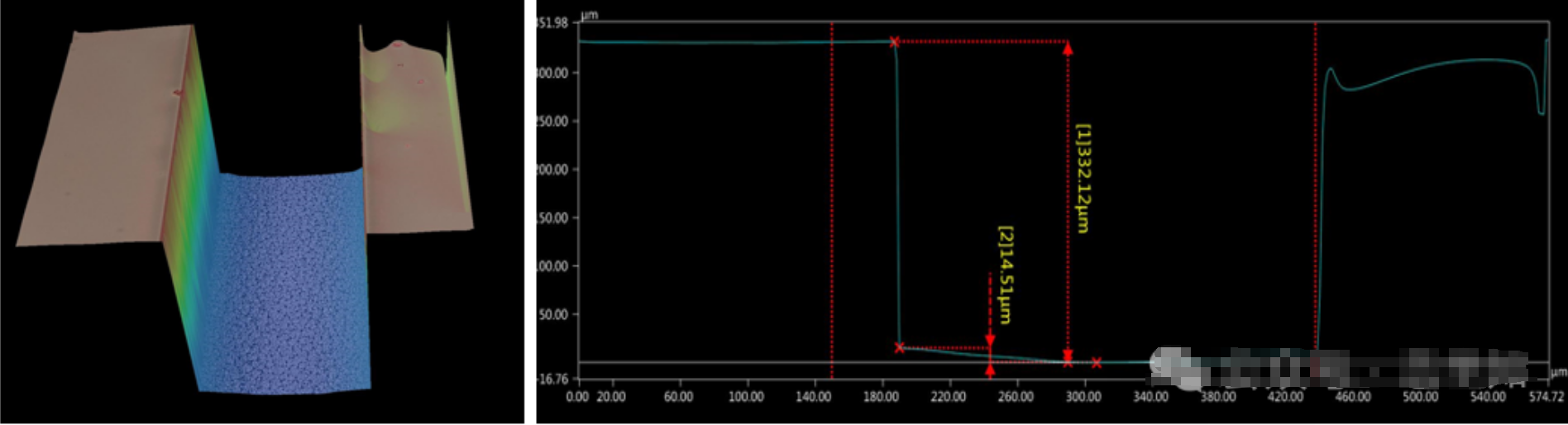
图 底部不平实际测量图
总结
反应气体流量、刻蚀阶段钝化气体流量、刻蚀/钝化时间比和刻蚀阶段反应室压力都会在某种程度上影响刻蚀侧壁形貌,但对各个形貌问题的影响规律并不一致,甚至出现此消彼长的现象,因此不可能仅仅通过简单改变某一参数来解决全部形貌问题。因此,我们MEMS行业的从业人员应该放弃傲慢与偏见,对工艺保持一颗崇敬的之心,去理解现实工艺加工中的不完美。同时也不要抛弃一颗理想浪漫的心,去追求不完美中的一点点可以做到完美的部分,相信技术一定是不停的被探索而趋于无限成熟。
*转载自微信公众号芯学知 https://mp.weixin.qq.com/s/D8hrM3sKNiwBaJBZl56Wkw
*声明:转载此文是出于传递更多信息之目的,若有来源标注措误或侵犯了您的合法权益,请与我们联系,我们将及时更正、删除,谢谢。
分享